

|
|
全新台式光源讓 10-100nm 應用更容易使用 |
|
|
EUV 應用包括度量、奈米尺度成像及電子光譜儀 |
|
|
由於高吸收率可以消除折射可能性,EUV 系統通常使用反射式光學元件 |
|
|
表面粗糙度相當關鍵,因為短波長會大幅增加散射 |
極紫外線 (EUV) 輻射涵蓋的波長頻帶約在 10nm 至 100nm 之間,也就是在 X 光和深紫外線 (DUV) 光譜範圍之間。藉由包括微影、奈米尺度成像及光譜儀等眾多 EUV 領域的沖壓應用的加入,近期投入許多心力專注於開發體積精巧的 EUV 來源,進而推出多款商用 EUV 光源。
幾乎所有材料都會大幅吸收 EUV 輻射,因此光學元件一定採用反射式而非透射式。由於波長短,EUV 光學元件的表面品質要求比可見光元件更為嚴苛。雖然 EUV 光學元件要求嚴苛而不易生產,但基於 EUV 輻射用於高分辨率成像、光譜儀及材料處理等應用的效益,仍然值得努力投入生產。
第一種可行的 EUV 輻射源,是只有在大型研究實驗室及微影公司能夠使用的巨型裝置,不過 EUV 技術近來的進展成果,已經打造出更精巧且更容易使用的台式 EUV 系統。高諧波產生 (HHG) 系統及毛細管放電雷射,是兩種前景較為看好的新型 EUV 台式來源,可產生低發散性的同調輻射光束。
體積精巧的新型 EUV 來源,正擴展各式各樣的新興 EUV 應用,包括高分辨率成像、電子光譜儀、分子及固態動力學研究,以及奈米加工。
EUV 系統需要在真空環境之中,因為 100nm 以下的波長無法透過空氣傳輸。同樣地,EUV 輻射幾乎在所有材料都具有極高的吸收率,因此 EUV 應用的光學元件幾乎都是反射式。短波長的散射較高,因此表面粗糙度、表面平整度及其他表面容差對 EUV 光學元件相當重要。一般使用於 EUV 應用的反射鏡類型為多層布拉格反射鏡,其中週期性堆疊兩種不同材料,可讓特定波長頻帶進行結構性的干涉及反射。部分入射光束會在堆疊中的各個介面反射。EUV 多層反射鏡的頻寬非常窄,達到 1nm 等級,因此這類 EUV 光學裝置必須特別符合來源波長。
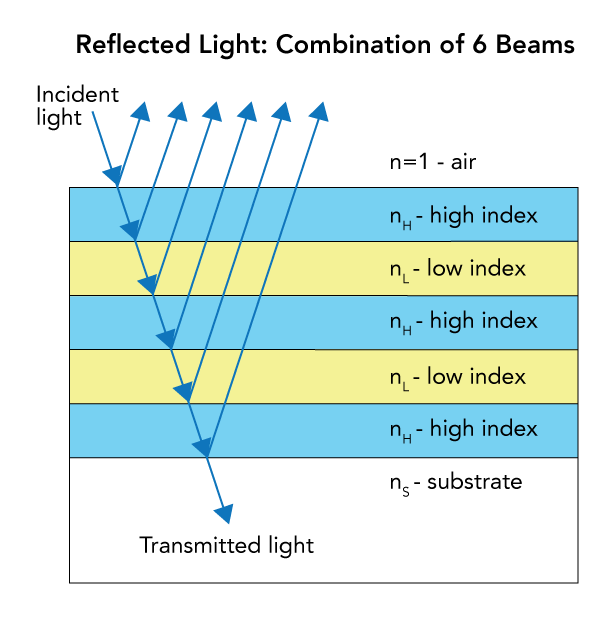
 為何極紫外線 (EUV) 平面反射鏡設計用於 13.5nm?
為何極紫外線 (EUV) 平面反射鏡設計用於 13.5nm?
 為何極紫外線 (EUV) 平面反射鏡使用單晶矽基材而非熔融石英?
為何極紫外線 (EUV) 平面反射鏡使用單晶矽基材而非熔融石英?
雖然部分 EUV 光學元件使用熔融石英基材,但愛特蒙特光學供應的極紫外線 (EUV) 平面反射鏡採用單晶矽基材,因為相較於熔融石英,這類材料具備卓越的熱穩定性。
 為何透射光學元件無法搭配使用 EUV 輻射?
為何透射光學元件無法搭配使用 EUV 輻射?
EUV 光子能量約 90eV,一般有機物質與金屬的游離能分別為 7-9eV 及 4-5eV。因此 EUV 光子易被吸收,產生光電子及次級電子,避免 EUV 輻射透射穿透所有物質。
 如果在樣本散射的光線沒有聚焦回到 CCD 偵測器影像,同調繞射成像 (CDI) 要如何產生影像?
如果在樣本散射的光線沒有聚焦回到 CCD 偵測器影像,同調繞射成像 (CDI) 要如何產生影像?
在物體散射的輻射,會於偵測器產生倒易空間繞射圖。逆傅立葉轉換演算法會套用至記錄圖形,重新建構影像。使用軟體將散射的繞射圖轉換為物體高度圖,而非使用透鏡系統在偵測器形成影像。
or view regional numbers
QUOTE TOOL
enter stock numbers to begin
Copyright 2023, Edmund Optics Inc., 14F., No.83, Sec. 4, Wenxin Road, Beitun District , Taichung City 406, Taiwan (R.O.C.)
California Consumer Privacy Act (CCPA): Do Not Sell My Information